概要
ドーピング技術を用いた温度補償の進歩により、シリコンMEMS振動子はタイミングデバイス市場で水晶振動子に対抗できるデバイスとして台頭してきました。ドーピング技術導入前は水晶振動子と比べて特性に大きな差があり、製品として使用できるレベルではありませんでした。しかし2010年代に入り、シリコンMEMS振動子の周波数温度依存性がシリコンへのウルトラハイドーピング(UHD)技術によって大きく改善されることが分かったことで大きく前進することとなりました。さらに設計の最適化により、水晶振動子を超える周波数の安定性が実現されることも分かりました。もう一つの課題が、シリコンは非圧電性であるため、水晶との互換性がないことでしたが、窒化アルミニウム(AIN)薄膜の導入により、この課題も解決され、水晶と同等の電気的等価回路を実現できるようになりました。
ドーピング技術による温度補償
ドーピング技術はシリコンMEMS振動子がタイミングデバイス市場で水晶振動子と戦えるようになった革新的な技術です。従来、水晶の温度変動は40℃から+85℃の範囲で±10ppm程度であるのに対し、標準シリコンは-約±1,500ppmという大きな温度変動がありました。応力補償やSiO2の追加材料など、様々な温度補償法が検討されましたが、それでも±150ppm程度と、水晶には遠く及びませんでした。
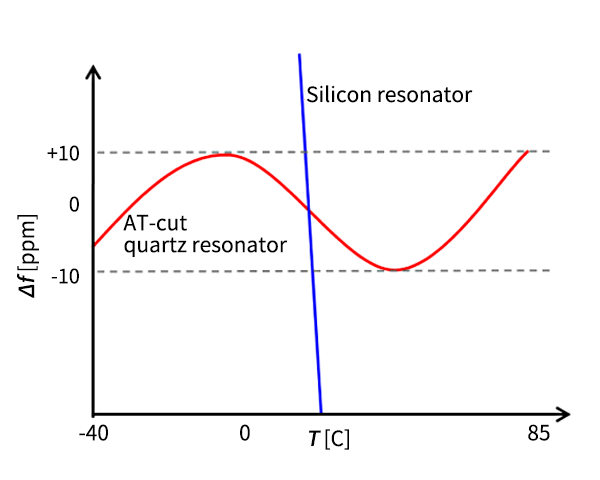
一方、Keys氏とHall氏の研究から、シリコンの弾性パラメータc11(T, n)、c12(T, n)、c44(T, n)の温度依存性がn型とp型ドーピングによって影響を受けることは、数十年前にすでに知られていました(1)(2)。しかし、シリコンMEMS振動子へドーピングを利用することは、2010年頃までMEMS業界では知られていませんでした。シリコンに歪みが生じると、電荷キャリアの伝導帯の間での挙動が変化、これによりスプリング効果が生じて、復元力が生じます。具体的には、シリコンの弾性定数は温度(T)とドーピングレベル(n)の両方に依存し、高濃度のドーピングレベルでは温度依存性が大きく影響を受けます。
初めて温度補償を行った高濃度のドープシリコンMEMS振動子の結果が、2010年から2011年に発表されました(3)~(5)。これらの研究では、シリコンMEMS振動子の周波数と温度特性の関係が一次補正されて、-40℃から+85℃の範囲で約±150ppmの温度変動という結果が得られました。ここでの問題は二次係数TCF2が負のままということであり、ドーパントやドーピング量に要因がありました。最終的に、シリコンにリンを高濃度にドーピングすることで、シリコンMEMS振動子の二次係数が正(TCF2~+15ppb/C2)になり、TCF1とTCF2の両方がゼロになる最適値が得られるという重要な発見が2015年になされました。これにより、±10ppmの安定性を持つ圧電変換シリコンMEMS振動子が実証されたのでした(6)。
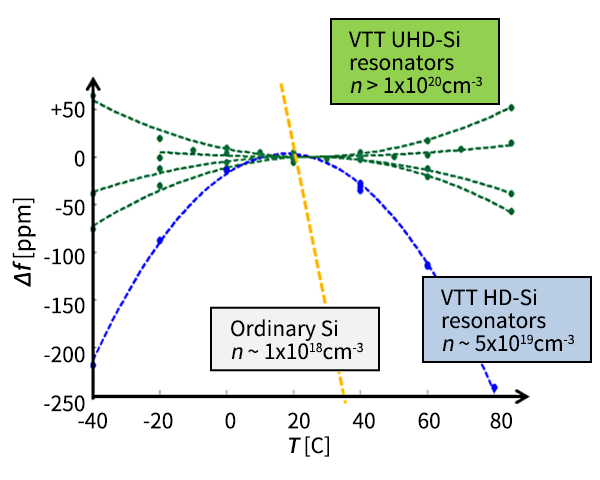
データは全て京セラ調べ
対象製品を同条件で比較
(続く…)
文献
(1) J. J. Hall : "Electronic Effects in the Elastic Constants of n-Type Silicon, "Physical Review, Vol.161, No.3, p.756 (1967) dx.doi.org/10.1103/PhysRev.161.756
(2) R. W. Keyes : "Electronic Effects in the Elastic Properties of Semiconductors", in Solid State Physics : Advances in Research and Applications, ed. by F. Seitz and D. Turnbull. Academic Press, Vol.20, pp.37-90 (1967)
(3) A. Hajjam, A. Rahafrooz, and S. Pourkamali : "Sub-100 ppb/C Temperature Stability in Thermally Actuated High Frequency Silicon Resonators via Degenerate Phosphorous Doping and Bias Current Optimization", in Proc. IEEE International Electron Device Meeting (IEDM), pp.7.5.1-7.5.4(2010)
(4) T. Pensala, A. Jaakkola, M. Prunnila, J. Dekker, "Temperature compensation of silicon MEMS resonators by heavy doping", Proc. IEEE International Ultrasonics Symposium, pp.1952-1955 (2011)
(5) A. K. Samarao, G. Casinovi, and F. Ayazi: "Passive TCF Compensation in High Q Silicon Micromechanical Resonators", in Proc. IEEE International Conference on Micro Electro Mechanical Systems, Hong Kong, pp.116-119 (2010) dx.doi.org/10.1109/MEMSYS.2010.5442553
(6) A. Jaakkola, P. Pekko, J. Dekker, M. Prunnila, and T. Pensala : "Second Order Temperature Compensated Piezoelectrically Driven 23MHz Heavily Doped Silicon Resonators with土10 ppm Temperature Stability", Proc. IEEE International Frequency Control Symposium, pp.420-422 (2015)
●ワンポイント用語解説●
京セラ電子部品公式マスコットキャラクターえれたん えれたん紹介ページはこちら
MEMS(メムス)とは?
「Micro Electro Mechanical Systems(微小な電子機械システム)」の略称。微細加工技術によって、機械要素部品・電子回路などを、一つのシリコン基板・ガラス基板などの上に組み込んだデバイスのことです。
関連リンク










